PECVD Recipes: Difference between revisions
| (36 intermediate revisions by 2 users not shown) | |||
| Line 10: | Line 10: | ||
*[https://docs.google.com/spreadsheets/d/1fTDNXxpf4tgNYLIEs_jvehG1KvtXqqTRDBI7sHNAVvo/edit#gid=0 SiO<sub>2</sub><nowiki> [PECVD 1] Current Process Control Data</nowiki>] |
*[https://docs.google.com/spreadsheets/d/1fTDNXxpf4tgNYLIEs_jvehG1KvtXqqTRDBI7sHNAVvo/edit#gid=0 SiO<sub>2</sub><nowiki> [PECVD 1] Current Process Control Data</nowiki>] |
||
**Lists film data, such as dep rate, stress, particle count, refractive index etc. |
|||
=== Old Data === |
|||
*[https://wiki.nanotech.ucsb.edu/wiki/Old_Deposition_Data_-_2021-12-15#SiO2_deposition_.28PECVD_.231.29 SiO<sub>2</sub><nowiki> [PECVD 1] Historical Data</nowiki>] - Oct. 2021 and earlier |
*[https://wiki.nanotech.ucsb.edu/wiki/Old_Deposition_Data_-_2021-12-15#SiO2_deposition_.28PECVD_.231.29 SiO<sub>2</sub><nowiki> [PECVD 1] Historical Data</nowiki>] - Oct. 2021 and earlier |
||
| Line 16: | Line 19: | ||
*[https://docs.google.com/spreadsheets/d/1DGU745SeunYz4sLs1LpGKbtOYX-tQyBHEvVYcMxHRKE/edit#gid= Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 1] Standard Recipe</nowiki>] |
*[https://docs.google.com/spreadsheets/d/1DGU745SeunYz4sLs1LpGKbtOYX-tQyBHEvVYcMxHRKE/edit#gid= Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 1] Standard Recipe</nowiki>] |
||
*[https://docs.google.com/spreadsheets/d/1fTDNXxpf4tgNYLIEs_jvehG1KvtXqqTRDBI7sHNAVvo/edit#gid=98787450 Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 1] Current Process Control Data</nowiki>] |
*[https://docs.google.com/spreadsheets/d/1fTDNXxpf4tgNYLIEs_jvehG1KvtXqqTRDBI7sHNAVvo/edit#gid=98787450 Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 1] Current Process Control Data</nowiki>] |
||
**Lists film data, such as dep rate, stress, particle count, refractive index etc. |
|||
=== Old Data === |
|||
*[https://wiki.nanotech.ucsb.edu/wiki/Old_Deposition_Data_-_2021-12-15#SiN_deposition_.28PECVD_.231.29 Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 1] Historical Data</nowiki>] - Oct. 2021 and earlier |
*[https://wiki.nanotech.ucsb.edu/wiki/Old_Deposition_Data_-_2021-12-15#SiN_deposition_.28PECVD_.231.29 Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 1] Historical Data</nowiki>] - Oct. 2021 and earlier |
||
| Line 28: | Line 34: | ||
*[https://wiki.nanotech.ucsb.edu/wiki/images/2/24/New_PECVD1-LS_SION-recipe_2014_LS_SION_recipe.pdf SiO<sub>x</sub>N<sub>y</sub> Standard Recipe] |
*[https://wiki.nanotech.ucsb.edu/wiki/images/2/24/New_PECVD1-LS_SION-recipe_2014_LS_SION_recipe.pdf SiO<sub>x</sub>N<sub>y</sub> Standard Recipe] |
||
*[https://docs.google.com/spreadsheets/d/1rixyzAAq6q08M5OwvZiDVoh3K8B566XKM-UZAQIAnsg/edit#gid=sharing SiO<sub>x</sub>N<sub>y</sub> Data 2014] - '' |
*[https://docs.google.com/spreadsheets/d/1rixyzAAq6q08M5OwvZiDVoh3K8B566XKM-UZAQIAnsg/edit#gid=sharing SiO<sub>x</sub>N<sub>y</sub> Data 2014] - ''Lists film data, such as dep rate, stress, particle count, refractive index etc.'' |
||
*[https://docs.google.com/spreadsheet/ccc?key=0AnwBU1s4JQo2dEttR2JSTkRoamR0SUZ4bE5QUW9uS2c&usp=sharing SiO<sub>x</sub>N<sub>y</sub>1000A Thickness uniformity 2014] |
*[https://docs.google.com/spreadsheet/ccc?key=0AnwBU1s4JQo2dEttR2JSTkRoamR0SUZ4bE5QUW9uS2c&usp=sharing SiO<sub>x</sub>N<sub>y</sub>1000A Thickness uniformity 2014] |
||
==Standard Cleaning Procedure (PECVD #1)== |
==Standard Cleaning Procedure (PECVD #1)== |
||
The cleaning procedure is very important in order to have consistent result on this tool and also to keep particulate count low. After each deposition you should clean the tool following instructions carefully. |
The cleaning procedure is very important in order to have consistent result on this tool and also to keep particulate count low. After each deposition you should clean the tool following instructions carefully. |
||
The clean is done in two steps: |
|||
#Wet cleaning (start cleaning by using a cleanroom wipe sprayed with DI. Wipe chamber sidewalls with it. Finish cleaning by using the cleanroom wipe sprayed with IPA. ) |
#'''Wet cleaning''' (start cleaning by using a cleanroom wipe sprayed with DI. Wipe chamber sidewalls with it. Finish cleaning by using the cleanroom wipe sprayed with IPA. ) |
||
#Load the recipe for cleaning "CF4/O2 Clean" ( |
#Load the recipe for plasma cleaning "'''''CF4/O2 Clean'''''" (run the recipe and it will pop-up asking for the cleaning time). Follow instructions regarding a required time for cleaning. |
||
# |
|||
{| class="wikitable" |
{| class="wikitable" |
||
| Line 44: | Line 51: | ||
|- |
|- |
||
|SiO<sub>2</sub> |
|SiO<sub>2</sub> |
||
|1 min clean for every 1 min dep |
|||
|TBD |
|||
|- |
|- |
||
|Si<sub>3</sub>N<sub>4</sub> |
|Si<sub>3</sub>N<sub>4</sub> |
||
|1 min clean for every 7 min dep |
|||
|TBD |
|||
|- |
|- |
||
|SiOxNy |
|SiOxNy |
||
|Same as |
|Same as SiO<sub>2</sub> |
||
|- |
|||
|a-Si |
|||
|Same time as Si<sub>3</sub>N<sub>4</sub> |
|||
|} |
|} |
||
# |
|||
===[https://wiki.nanotech.ucsb.edu/w/images/7/72/PECVD1-cleaning.png Standard Cleaning Recipe (PECVD#1): "CF4/O2 Clean"]=== |
===[https://wiki.nanotech.ucsb.edu/w/images/7/72/PECVD1-cleaning.png Standard Cleaning Recipe (PECVD#1): "CF4/O2 Clean"]=== |
||
| Line 65: | Line 73: | ||
*[https://docs.google.com/spreadsheets/d/1cYK-k669vf8YO2q2YCGa3gTdaDI3I3M-a9KR5RDlZWY/edit#gid= SiO<sub>2</sub><nowiki> [PECVD 2] New Standard Recipe</nowiki>] - "''STD SiO2 v2''" |
*[https://docs.google.com/spreadsheets/d/1cYK-k669vf8YO2q2YCGa3gTdaDI3I3M-a9KR5RDlZWY/edit#gid= SiO<sub>2</sub><nowiki> [PECVD 2] New Standard Recipe</nowiki>] - "''STD SiO2 v2''" |
||
*[https://docs.google.com/spreadsheets/d/1wCEcFj6ZMHR4QifngLXwz6dqbyf8hsVKu7bQbMS6EoA/edit#gid= SiO<sub>2</sub><nowiki> [PECVD 2] Old Standard Recipe</nowiki>] - "''STD SiO2''" |
**[https://docs.google.com/spreadsheets/d/1wCEcFj6ZMHR4QifngLXwz6dqbyf8hsVKu7bQbMS6EoA/edit#gid= SiO<sub>2</sub><nowiki> [PECVD 2] Old Standard Recipe</nowiki>] - "''STD SiO2''" |
||
*[https://docs.google.com/spreadsheets/d/1iSW1eAAg824y9PYYLG9aiaw53PEJ-f9ofylpVlCDq9Y/edit#gid=1313651154 SiO<sub>2</sub><nowiki> [PECVD 2] Current Process Control Data</nowiki>] |
*[https://docs.google.com/spreadsheets/d/1iSW1eAAg824y9PYYLG9aiaw53PEJ-f9ofylpVlCDq9Y/edit#gid=1313651154 SiO<sub>2</sub><nowiki> [PECVD 2] Current Process Control Data</nowiki>] |
||
**Lists film data, such as dep rate, stress, particle count, refractive index etc. |
|||
*[https://wiki.nanotech.ucsb.edu/wiki/Old_Deposition_Data_-_2021-12-15#SiO2_deposition_.28PECVD_.232.29 SiO<sub>2</sub><nowiki> [PECVD 2] Historical Data</nowiki>] - Before Oct. 2021 |
*[https://wiki.nanotech.ucsb.edu/wiki/Old_Deposition_Data_-_2021-12-15#SiO2_deposition_.28PECVD_.232.29 SiO<sub>2</sub><nowiki> [PECVD 2] Historical Data</nowiki>] - Before Oct. 2021 |
||
*SiO<sub>2</sub> deposition rate at 150C is 35nm/min |
|||
==SiN deposition (PECVD #2)== |
==SiN deposition (PECVD #2)== |
||
*[https://docs.google.com/spreadsheets/d/1JBXEfRGemFJK81RkHfxS0cTucb3viUL7hMGzmKRD5uU/edit#gid= Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] New Standard Recipe</nowiki>] - "''STD Si3N4 v3''" |
*[https://docs.google.com/spreadsheets/d/1JBXEfRGemFJK81RkHfxS0cTucb3viUL7hMGzmKRD5uU/edit#gid= Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] New Standard Recipe</nowiki>] - "''STD Si3N4 v3''" |
||
*[https://docs.google.com/spreadsheets/d/1KS4HfhUJyYVep4H6CRAKpMRP5TA31F0qD-obQkKRnEI/edit#gid= Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] Old Standard Recipe</nowiki>] - "''Nitride2''" |
**[https://docs.google.com/spreadsheets/d/1KS4HfhUJyYVep4H6CRAKpMRP5TA31F0qD-obQkKRnEI/edit#gid= Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] Old Standard Recipe</nowiki>] - "''Nitride2''" |
||
*[https://docs.google.com/spreadsheets/d/1iSW1eAAg824y9PYYLG9aiaw53PEJ-f9ofylpVlCDq9Y/edit#gid=773875841 Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] Current Process Control Data</nowiki>] |
*[https://docs.google.com/spreadsheets/d/1iSW1eAAg824y9PYYLG9aiaw53PEJ-f9ofylpVlCDq9Y/edit#gid=773875841 Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] Current Process Control Data</nowiki>] |
||
**Lists film data, such as dep rate, stress, particle count, refractive index etc. |
|||
*[https://wiki.nanotech.ucsb.edu/wiki/Old_Deposition_Data_-_2021-12-15#SiN_deposition_.28PECVD_.232.29 Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] Historical Data</nowiki>] - Before Oct. 2021 |
*[https://wiki.nanotech.ucsb.edu/wiki/Old_Deposition_Data_-_2021-12-15#SiN_deposition_.28PECVD_.232.29 Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] Historical Data</nowiki>] - Before Oct. 2021 |
||
| Line 79: | Line 91: | ||
''Low-Stress Silicon Nitride, Si<sub>3</sub>N<sub>4</sub> (< ±100 MPa)'' |
''Low-Stress Silicon Nitride, Si<sub>3</sub>N<sub>4</sub> (< ±100 MPa)'' |
||
*[https://docs.google.com/spreadsheets/d/19VQ6ytYbZ5SsAiXzgWqwlyJUqgjWb8x_eyv7L8DvtwM/edit#gid= Low Stress Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] New Standard Recipe</nowiki>] - "'' |
*[https://docs.google.com/spreadsheets/d/19VQ6ytYbZ5SsAiXzgWqwlyJUqgjWb8x_eyv7L8DvtwM/edit#gid= Low Stress Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] New Standard Recipe</nowiki>] - "''STD LS-Si3N4 v4''" |
||
*[https://docs.google.com/spreadsheets/d/1DzzI7aE61R7c6gyk6cGBdm9FtGrApiNJ4AL90ll2C8k/edit#gid= Low Stress Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] Standard Recipe</nowiki>] - "'' Old LSNitride2 recipe ''" |
**[https://docs.google.com/spreadsheets/d/1DzzI7aE61R7c6gyk6cGBdm9FtGrApiNJ4AL90ll2C8k/edit#gid= Low Stress Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] Old Standard Recipe</nowiki>] - "'' Old LSNitride2 recipe ''" |
||
*[https://docs.google.com/spreadsheets/d/1iSW1eAAg824y9PYYLG9aiaw53PEJ-f9ofylpVlCDq9Y/edit#gid=584923738 Low Stress Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] Current Process Control Data</nowiki>] |
*[https://docs.google.com/spreadsheets/d/1iSW1eAAg824y9PYYLG9aiaw53PEJ-f9ofylpVlCDq9Y/edit#gid=584923738 Low Stress Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] Current Process Control Data</nowiki>] |
||
*[https://docs.google.com/spreadsheets/d/1iSW1eAAg824y9PYYLG9aiaw53PEJ-f9ofylpVlCDq9Y/edit#gid=203400760 Plots of Low-Stress Si<sub>3</sub>N<sub>4</sub> Process Control Data] |
*[https://docs.google.com/spreadsheets/d/1iSW1eAAg824y9PYYLG9aiaw53PEJ-f9ofylpVlCDq9Y/edit#gid=203400760 Plots of Low-Stress Si<sub>3</sub>N<sub>4</sub> Process Control Data] |
||
**Lists film data, such as dep rate, stress, particle count, refractive index etc. |
|||
*[[Old Deposition Data - 2021-12-15#Low-Stress SiN deposition .28PECVD .232.29|Low Stress Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] Historical Data - Before Oct. 2021</nowiki>]] |
*[[Old Deposition Data - 2021-12-15#Low-Stress SiN deposition .28PECVD .232.29|Low Stress Si<sub>3</sub>N<sub>4</sub><nowiki> [PECVD 2] Historical Data - Before Oct. 2021</nowiki>]] |
||
*:''Old Versions of the recipe:'' |
*:''Old Versions of the recipe:'' |
||
*:''[https://wiki.nanotech.ucsb.edu/wiki/images/a/a5/New_AdvPECVD-LS_Nitride2_300C_standard_recipe_LS_Nitride2_standard_recipe.pdf LS Nitride2 Standard Recipe 2014-5/9/2018]'' |
*:''[https://wiki.nanotech.ucsb.edu/wiki/images/a/a5/New_AdvPECVD-LS_Nitride2_300C_standard_recipe_LS_Nitride2_standard_recipe.pdf LS Nitride2 Standard Recipe 2014-5/9/2018]'' |
||
*:''[https://wiki.nanotech.ucsb.edu/wiki/images/0/01/STD_LSNitride2_5-9-18.pdf STD LSNitride2 5/9/2018]'' |
*:''[https://wiki.nanotech.ucsb.edu/wiki/images/0/01/STD_LSNitride2_5-9-18.pdf STD LSNitride2 5/9/2018]'' |
||
===Low-Stress SiN 3xTime (PECVD #2)=== |
|||
''This Low-Stress SiN recipe is more stable over time (months), because each step is 3x longer (so each compressive/tensile layer is thicker), making it less susceptible to RF ignition delays as the grounding strap is etched over time. – 2024-09 [[Demis D. John|Demis]] & [[Biljana Stamenic|Biljana]]'' |
|||
*Recipe: "''[https://docs.google.com/spreadsheets/d/1OQp_sux5YEgpcyH3sf0JCwTOhvoi_LSYKOUMRR4Umh4?usp=drive_fs STD LS-Si3N4 3xTime v1]"'' |
|||
*[https://docs.google.com/spreadsheets/d/15aKkk-fIojIDgQfsVlB3lhex-U3Q0edVdNCkzoGBo1Q/edit?usp=sharing Process Control Data]: Lists film data, such as dep rate, stress, particle count, refractive index etc. |
|||
*[https://docs.google.com/spreadsheets/d/15aKkk-fIojIDgQfsVlB3lhex-U3Q0edVdNCkzoGBo1Q/edit?gid=974005628#gid=974005628 Process Control Charts/Plots]: Calibration control limits versus date |
|||
==Amorphous-Si deposition (PECVD #2)== |
==Amorphous-Si deposition (PECVD #2)== |
||
*[[PECVD-2 - a-Si Recipe and Dep process (2025)|a-Si Recipe and Dep process]] 2025-11 |
|||
*[https://wiki.nanotech.ucsb.edu/wiki/images/9/9d/03-Amorphous-Si-PECVD-2.pdf Amorphous Si Deposition Recipe] |
|||
**''Developed by Ryan Hersey & Skyler Palatnik, Group of Prof. Max Millar-Blanchaer'' |
|||
*[https://wiki.nanotech.ucsb.edu/wiki/images/0/09/ASi_deposition_and_film_stress_using_AV_dep_tool.pdf Amorphous Si Film Characterization and Stress] |
|||
*[https://wiki.nanotech.ucsb.edu/wiki/images/9/9d/03-Amorphous-Si-PECVD-2.pdf Amorphous Si Deposition Recipe] (2013-09, Ning Cao) |
|||
*[https://wiki.nanotech.ucsb.edu/wiki/images/0/09/ASi_deposition_and_film_stress_using_AV_dep_tool.pdf Amorphous Si Film - Characterization and Stress] - DOE/recipe variations |
|||
==Standard Cleaning Procedure (PECVD #2)== |
==Standard Cleaning Procedure (PECVD #2)== |
||
The cleaning procedure is very important in order to have consistent result on this tool and also to keep particulate count low. After each deposition you should clean the tool following instructions carefully. The clean is done in two steps: |
The cleaning procedure is very important in order to have consistent result on this tool and also to keep particulate count low. After each deposition you should clean the tool following instructions carefully. The clean is done in two steps: |
||
# |
#If > 29min (season+dep. time) Wet cleaning: Start cleaning by using a cleanroom wipe sprayed with DI. Wipe upper chamber sidewalls with it. Finish cleaning by using the cleanroom wipe sprayed with IPA & wiping again. Do not clean shower-head! |
||
#Load the recipe for cleaning "STD CF<sub>4</sub>/O<sub>2</sub> Clean" (edit the recipe and change ONLY time of cleaning). Follow instructions regarding required time for cleaning. |
#Load the recipe for cleaning "STD CF<sub>4</sub>/O<sub>2</sub> Clean" (edit the recipe and change ONLY time of cleaning). Follow instructions regarding required time for cleaning. |
||
===[https://wiki. |
===[https://wiki.nanofab.ucsb.edu/wiki/File:STD_CF4-O2_Clean_PECVD2.jpg Standard Clean Recipe (PECVD#2): "STD CF4/O2 Clean"]=== |
||
Click the above link for a screenshot of the standard cleaning recipe, for which you will enter a custom time. The recipe is set up so that it will pop up a window for the cleaning time upon running the recipe - you do not need to edit the recipe before running it. |
Click the above link for a screenshot of the standard cleaning recipe, for which you will enter a custom time. The recipe is set up so that it will pop up a window for the cleaning time upon running the recipe - you do not need to edit the recipe before running it. |
||
| Line 111: | Line 133: | ||
|- |
|- |
||
|SiO<sub>2</sub> |
|SiO<sub>2</sub> |
||
| |
|1min. clean for every 1min. deposition |
||
|- |
|- |
||
|Si<sub>3</sub>N<sub>4</sub> |
|Si<sub>3</sub>N<sub>4</sub> |
||
| |
|1min. clean for every 7min. of deposition |
||
|- |
|- |
||
|a-Si |
|||
|1.5 min clean for every 1min of deposition |
|||
|- |
|||
|a-Si (max 30min long dep. in one single run) |
|||
|Wet Clean the Upper Lid/Chamber |
|||
DI water then Isopropyl Alcohol on chamber wall & portholes |
|||
|- |
|||
|Other films:(max 60min long dep. in one single run) |
|||
|If > 29min total dep time |
|If > 29min total dep time |
||
(Season + Dep) |
(Season + Dep) |
||
|Wet Clean the Upper Lid/Chamber |
|||
Wet Clean the Upper Lid/Chamber |
|||
DI water then Isopropyl Alcohol on chamber wall & portholes |
DI water then Isopropyl Alcohol on chamber wall & portholes |
||
|} |
|} |
||
| Line 128: | Line 160: | ||
==Process Control Data (Unaxis ICP-PECVD)== |
==Process Control Data (Unaxis ICP-PECVD)== |
||
''Regularly-run depositions and measurements of film properties over time - executed by [https://nanofab.ucsb.edu/workforce NanoFab Interns].'' |
|||
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=417334948https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=417334948 ICP-PECVD Process Control Plots] - ''Plots of all Process Control data'' |
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=417334948https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=417334948 ICP-PECVD Process Control Plots] - ''Plots of all Process Control data'' |
||
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=0 Low Deposition Rate SiO<sub>2</sub>] |
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=0 Low Deposition Rate SiO<sub>2</sub>] |
||
| Line 137: | Line 169: | ||
==Low Deposition Rate SiO<sub>2</sub> [ICP-PECVD]== |
==Low Deposition Rate SiO<sub>2</sub> [ICP-PECVD]== |
||
*[https://docs.google.com/spreadsheets/d/ |
*[https://docs.google.com/spreadsheets/d/1mobnAIH70a9eFbCkMnza2WfpI2uRUWtLlz0cLK1Ljuo/edit?gid=1554182668#gid=1554182668 Low Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Standard Recipe</nowiki>] - "''SiO2 LDR250C-new May 2024'' |
||
*[https://docs.google.com/spreadsheets/d/1zRqnfyQXFU10SPIy-YMQdjserJTUDrASLCgNke_gXGQ/edit#gid=2001468501 Low Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Standard Recipe</nowiki>] - "''SiO2 LDR250C- after May 2024''" |
|||
**[https://docs.google.com/spreadsheets/d/1wocoCPOOEDQcZbXJJNaZs1sr9dXBZpn1wUyglL8IQrI/edit#gid=1199123007 Old Recipe] - |
|||
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=0 Low Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Process Control Data</nowiki>] |
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=0 Low Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Process Control Data</nowiki>] |
||
**Lists film data, such as dep rate, stress, particle count, refractive index etc. |
|||
=== Old Data === |
|||
* [https://docs.google.com/spreadsheets/d/17ft9jrHcCFCp2830RsLwQq5lHuupWATXT91SreG8WYY/edit#gid=143856038 Low Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Standard Recipe</nowiki>] - "''SiO2 LDR250C - replaced on May 2024''" |
|||
* [https://docs.google.com/spreadsheets/d/1wocoCPOOEDQcZbXJJNaZs1sr9dXBZpn1wUyglL8IQrI/edit#gid=1199123007 Old Recipe] - 2019 |
|||
*[https://wiki.nanotech.ucsb.edu/wiki/Old_Deposition_Data_-_2021-12-15#SiO2_LDR_250C_Deposition_.28Unaxis_VLR.29 Low Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Historical Data</nowiki>] - before Oct. 2021 |
*[https://wiki.nanotech.ucsb.edu/wiki/Old_Deposition_Data_-_2021-12-15#SiO2_LDR_250C_Deposition_.28Unaxis_VLR.29 Low Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Historical Data</nowiki>] - before Oct. 2021 |
||
==High Deposition Rate SiO<sub>2</sub> [ICP-PECVD]== |
==High Deposition Rate SiO<sub>2</sub> [ICP-PECVD]== |
||
*[https://docs.google.com/spreadsheets/d/13KUlUujEWSLOH54Ibd52YNJPZcAc7ELShI2RAqM6H-Y/edit#gid=117484667 High Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Standard Recipe</nowiki>] - "''SiO2 HDR250C-until May 2024''" |
|||
*[https://docs.google.com/spreadsheets/d/1D1muKxWWWbOis02lrKJTE-6awkEsjpIyyA9QRK83JEA/edit#gid=117484667 High Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Standard Recipe</nowiki>] - "''SiO2 HDR250C-after May 2024''" |
|||
**[https://docs.google.com/spreadsheets/d/1OxHi5r9ifNvF8ODpIk6aoRevb4RdbbykwPVMm1g-yi4/edit#gid=1199123007 Old Recipe] |
|||
*[https://docs.google.com/spreadsheets/d/1x0mB4ySSUfEAfRehAx7k_k3BJuTMczaRxQgxsTAFfo4/edit?gid=744785272#gid=744785272 High Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Standard Recipe</nowiki>] - "''SiO2 HDR250C-new May 2024''" |
|||
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=1459210138 High Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Current Process Control Data</nowiki>] |
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=1459210138 High Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Current Process Control Data</nowiki>] |
||
**Lists film data, such as dep rate, stress, particle count, refractive index etc. |
|||
=== Old Data === |
|||
*[https://docs.google.com/spreadsheets/d/13KUlUujEWSLOH54Ibd52YNJPZcAc7ELShI2RAqM6H-Y/edit#gid=117484667 High Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Standard Recipe</nowiki>] - "''SiO2 HDR250C-replace on May 2024''" |
|||
*[https://docs.google.com/spreadsheets/d/1OxHi5r9ifNvF8ODpIk6aoRevb4RdbbykwPVMm1g-yi4/edit#gid=1199123007 Old Recipe] - 2019 |
|||
*[https://wiki.nanotech.ucsb.edu/wiki/Old_Deposition_Data_-_2021-12-15#SiO2_HDR_250C_Deposition_.28Unaxis_VLR.29 High Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Historical Data</nowiki>] |
*[https://wiki.nanotech.ucsb.edu/wiki/Old_Deposition_Data_-_2021-12-15#SiO2_HDR_250C_Deposition_.28Unaxis_VLR.29 High Deposition Rate SiO<sub>2</sub><nowiki> [ICP-PECVD] - Historical Data</nowiki>] |
||
==Gap-Fill SiO<sub>2</sub> [ICP-PECVD]== |
|||
''Recipe designed by [https://scholar.google.com/citations?user=kur3-cEAAAAJ&hl=en&oi=ao Warren Jin], please consider our [https://wiki.nanotech.ucsb.edu/wiki/Frequently_Asked_Questions#Publications_acknowledging_the_Nanofab publication policy] if you publish using this recipe.'' |
|||
'''NOTE:''' Please contact tool [[Tony Bosch|supervisor]] before running this recipe - this recipe must often be scheduled to prevent excessive chamber maintenance. |
|||
Able to effectively fill ~1:1 and ~1:2 aspect ratio gaps in Silicon and Glass structures (eg. waveguides/optical gratings) with void-free filling. |
|||
The recipe uses a high 400W RF Bias to reduce buildup on corners that causes voids during growth. |
|||
*Category = <code>SiO2 GapFill - Std.</code> |
|||
*FLOW: <code>SiO2 GapFill 250C</code> |
|||
**Will run the sequence <code>SiO2 GapFill 250C 450W</code>. Do not change this! |
|||
*STEP (edit TIME only): <code>SiO2 GapFill 250C</code> |
|||
*Deposition rate = 99.968nm/min [9/20/23] |
|||
==Si<sub>3</sub>N<sub>4</sub> [ICP-PECVD]== |
==Si<sub>3</sub>N<sub>4</sub> [ICP-PECVD]== |
||
*[https://docs.google.com/spreadsheets/d/ |
*[https://docs.google.com/spreadsheets/d/18nE-iTLLH4QIq3wadHVgjVuZ215o9xUz_aCX2WDdges/edit?gid=638997025#gid=638997025 Si<sub>3</sub>N<sub>4</sub><nowiki> [ICP-PECVD] - Standard Recipe</nowiki>] - "''SiN 250C-new May 2024''" |
||
**[https://docs.google.com/spreadsheets/d/1VrgS0cB2OcdZVTCnDAesgQCLRaAgEB_Iajc_OrhXOo0/edit#gid=1199123007 Old Recipe] |
|||
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=1670372499 Si<sub>3</sub>N<sub>4</sub><nowiki> [ICP-PECVD] - Current Process Control Data</nowiki>] |
* [https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=1670372499 Si<sub>3</sub>N<sub>4</sub><nowiki> [ICP-PECVD] - Current Process Control Data</nowiki>] |
||
** Lists film data, such as dep rate, stress, particle count, refractive index etc. |
|||
=== Old Data === |
|||
*[https://docs.google.com/spreadsheets/d/1Np5uJ1bw81MxHlDD0qs5Jh_hj7nCSznQTsSEELlT414/edit?usp=sharing Si<sub>3</sub>N<sub>4</sub><nowiki> [ICP-PECVD] - Standard Recipe</nowiki>] - "''SiN 250C- replaced on May 2024''" |
|||
*[https://docs.google.com/spreadsheets/d/1VrgS0cB2OcdZVTCnDAesgQCLRaAgEB_Iajc_OrhXOo0/edit#gid=1199123007 Old Recipe] - 2019 |
|||
*[https://wiki.nanotech.ucsb.edu/wiki/Old_Deposition_Data_-_2021-12-15#SiN_250C_deposition_.28Unaxis_VLR.29 Si<sub>3</sub>N<sub>4</sub><nowiki> [ICP-PECVD] - Historical Data</nowiki>] - before Oct. 2021 |
*[https://wiki.nanotech.ucsb.edu/wiki/Old_Deposition_Data_-_2021-12-15#SiN_250C_deposition_.28Unaxis_VLR.29 Si<sub>3</sub>N<sub>4</sub><nowiki> [ICP-PECVD] - Historical Data</nowiki>] - before Oct. 2021 |
||
==Low Stress Si<sub>3</sub>N<sub>4</sub> [ICP-PECVD]== |
==Low Stress Si<sub>3</sub>N<sub>4</sub> [ICP-PECVD]== |
||
*[https://docs.google.com/spreadsheets/d/ |
*[https://docs.google.com/spreadsheets/d/1xchMuXlPABSKcW-rMau8B-cw_jnJnwI9qpXqDLUQ8sU/edit?gid=1239658204#gid=1239658204 Low Stress Si<sub>3</sub>N<sub>4</sub><nowiki> [ICP-PECVD] - Standard Recipe</nowiki>] - "''SiN Low Stress 250C-new May 2024''" |
||
**[https://docs.google.com/spreadsheets/d/1i2mE2K12EEulnCbO9KuU9PCcvHAmcGxTIXUF8x4IOWk/edit#gid=1199123007 Old Recipe] |
|||
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=1517031044 Low Stress Si<sub>3</sub>N<sub>4</sub><nowiki> [ICP-PECVD] - Current Process Control Data</nowiki>] |
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=1517031044 Low Stress Si<sub>3</sub>N<sub>4</sub><nowiki> [ICP-PECVD] - Current Process Control Data</nowiki>] |
||
**Lists film data, such as dep rate, stress, particle count, refractive index etc. |
|||
=== Old Data === |
|||
* [https://docs.google.com/spreadsheets/d/1JuQlCU-mozIUJx9z9aQdisIJyFhv1r9AWI8EWeOnsPo/edit#gid=82816489 Low Stress Si<sub>3</sub>N<sub>4</sub><nowiki> [ICP-PECVD] - Standard Recipe</nowiki>] - "''SiN Low Stress 250C - replaced on May 2024''" |
|||
*[https://docs.google.com/spreadsheets/d/1i2mE2K12EEulnCbO9KuU9PCcvHAmcGxTIXUF8x4IOWk/edit#gid=1199123007 Old Recipe] - 2019 |
|||
==Standard Seasoning Procedure [ICP-PECVD]== |
|||
You must edit the seasoning recipes (SiO2 Seasoning - Std, SiN seasoning - Std). You are allowed to change only seasoning time [time needed to coat chamber walls with ~200nm of film]. |
|||
Seasoning recipes: |
|||
*[https://docs.google.com/spreadsheets/d/1S01xgtxFEJ4q7GLHfo-96yYKxer8nGlB/edit?gid=1944526099#gid=1944526099 SiO<sub>2</sub> seasoning - Std ] |
|||
*[https://docs.google.com/spreadsheets/d/1S3BFJIn9oAq2bxg6PDe9RY_6Fvkc36ki/edit?gid=1218243940#gid=1218243940 SiN seasoning - Std ] |
|||
==Standard Cleaning Procedure [ICP-PECVD]== |
==Standard Cleaning Procedure [ICP-PECVD]== |
||
| Line 174: | Line 241: | ||
===Standard Clean Recipe=== |
===Standard Clean Recipe=== |
||
''To Be Added'' |
|||
*[https://docs.google.com/spreadsheets/d/1S3DzvJJahNTwGXsn0GDyg2FiourGffiy/edit?gid=2021404224#gid=2021404224 Post Deposition Clean 250C ] |
|||
==General Recipe Notes (Unaxis VLR ICP-PECVD)== |
==General Recipe Notes (Unaxis VLR ICP-PECVD)== |
||
Latest revision as of 23:54, 26 November 2025
Back to Vacuum Deposition Recipes.
PECVD 1 (PlasmaTherm 790)
PECVD 1 Process Control Plots - Plots of all process control data
SiO2 deposition (PECVD #1)
- SiO2 [PECVD 1] Current Process Control Data
- Lists film data, such as dep rate, stress, particle count, refractive index etc.
Old Data
- SiO2 [PECVD 1] Historical Data - Oct. 2021 and earlier
SiN deposition (PECVD #1)
- Si3N4 [PECVD 1] Standard Recipe
- Si3N4 [PECVD 1] Current Process Control Data
- Lists film data, such as dep rate, stress, particle count, refractive index etc.
Old Data
- Si3N4 [PECVD 1] Historical Data - Oct. 2021 and earlier
Low Stress Si3N4 (PECVD#1)
- Low Stress Si3N4 [PECVD 1] Standard Recipe
- Low Stress Si3N4 [PECVD 1] Historical Data - 2021-10 and earlier
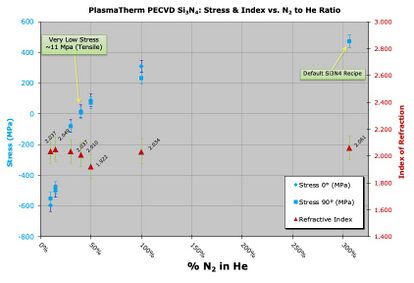
Example of Si3N4 modified stress via. varying N2 flow. Refractive index is relatively constant (one outlier), and stress varies continuously from tensile to compressive. (Demis D. John 2011, Blumenthal Group)
SiOxNy deposition (PECVD #1)
- SiOxNy Standard Recipe
- SiOxNy Data 2014 - Lists film data, such as dep rate, stress, particle count, refractive index etc.
- SiOxNy1000A Thickness uniformity 2014
Standard Cleaning Procedure (PECVD #1)
The cleaning procedure is very important in order to have consistent result on this tool and also to keep particulate count low. After each deposition you should clean the tool following instructions carefully.
The clean is done in two steps:
- Wet cleaning (start cleaning by using a cleanroom wipe sprayed with DI. Wipe chamber sidewalls with it. Finish cleaning by using the cleanroom wipe sprayed with IPA. )
- Load the recipe for plasma cleaning "CF4/O2 Clean" (run the recipe and it will pop-up asking for the cleaning time). Follow instructions regarding a required time for cleaning.
| Film Dep'd | Cleaning Time |
|---|---|
| SiO2 | 1 min clean for every 1 min dep |
| Si3N4 | 1 min clean for every 7 min dep |
| SiOxNy | Same as SiO2 |
| a-Si | Same time as Si3N4 |
Standard Cleaning Recipe (PECVD#1): "CF4/O2 Clean"
Click the above link for a screenshot of the standard cleaning recipe, for which you will enter a custom time. The recipe is set up so that it will pop up a window for the cleaning time upon running the recipe - you do not need to edit the recipe before running it.
PECVD 2 (Advanced Vacuum)
PECVD 2 Process Control Plots - Plots of all process control data
SiO2 deposition (PECVD #2)
- SiO2 [PECVD 2] New Standard Recipe - "STD SiO2 v2"
- SiO2 [PECVD 2] Old Standard Recipe - "STD SiO2"
- SiO2 [PECVD 2] Current Process Control Data
- Lists film data, such as dep rate, stress, particle count, refractive index etc.
- SiO2 [PECVD 2] Historical Data - Before Oct. 2021
- SiO2 deposition rate at 150C is 35nm/min
SiN deposition (PECVD #2)
- Si3N4 [PECVD 2] New Standard Recipe - "STD Si3N4 v3"
- Si3N4 [PECVD 2] Old Standard Recipe - "Nitride2"
- Si3N4 [PECVD 2] Current Process Control Data
- Lists film data, such as dep rate, stress, particle count, refractive index etc.
- Si3N4 [PECVD 2] Historical Data - Before Oct. 2021
Low-Stress SiN deposition (PECVD #2)
Low-Stress Silicon Nitride, Si3N4 (< ±100 MPa)
- Low Stress Si3N4 [PECVD 2] New Standard Recipe - "STD LS-Si3N4 v4"
- Low Stress Si3N4 [PECVD 2] Old Standard Recipe - " Old LSNitride2 recipe "
- Low Stress Si3N4 [PECVD 2] Current Process Control Data
- Plots of Low-Stress Si3N4 Process Control Data
- Lists film data, such as dep rate, stress, particle count, refractive index etc.
- Low Stress Si3N4 [PECVD 2] Historical Data - Before Oct. 2021
- Old Versions of the recipe:
- LS Nitride2 Standard Recipe 2014-5/9/2018
- STD LSNitride2 5/9/2018
Low-Stress SiN 3xTime (PECVD #2)
This Low-Stress SiN recipe is more stable over time (months), because each step is 3x longer (so each compressive/tensile layer is thicker), making it less susceptible to RF ignition delays as the grounding strap is etched over time. – 2024-09 Demis & Biljana
- Recipe: "STD LS-Si3N4 3xTime v1"
- Process Control Data: Lists film data, such as dep rate, stress, particle count, refractive index etc.
- Process Control Charts/Plots: Calibration control limits versus date
Amorphous-Si deposition (PECVD #2)
- a-Si Recipe and Dep process 2025-11
- Developed by Ryan Hersey & Skyler Palatnik, Group of Prof. Max Millar-Blanchaer
- Amorphous Si Deposition Recipe (2013-09, Ning Cao)
- Amorphous Si Film - Characterization and Stress - DOE/recipe variations
Standard Cleaning Procedure (PECVD #2)
The cleaning procedure is very important in order to have consistent result on this tool and also to keep particulate count low. After each deposition you should clean the tool following instructions carefully. The clean is done in two steps:
- If > 29min (season+dep. time) Wet cleaning: Start cleaning by using a cleanroom wipe sprayed with DI. Wipe upper chamber sidewalls with it. Finish cleaning by using the cleanroom wipe sprayed with IPA & wiping again. Do not clean shower-head!
- Load the recipe for cleaning "STD CF4/O2 Clean" (edit the recipe and change ONLY time of cleaning). Follow instructions regarding required time for cleaning.
Standard Clean Recipe (PECVD#2): "STD CF4/O2 Clean"
Click the above link for a screenshot of the standard cleaning recipe, for which you will enter a custom time. The recipe is set up so that it will pop up a window for the cleaning time upon running the recipe - you do not need to edit the recipe before running it.
Clean Times (PECVD#2)
| Film Deposited | Cleaning Time (Dry) |
|---|---|
| SiO2 | 1min. clean for every 1min. deposition |
| Si3N4 | 1min. clean for every 7min. of deposition |
| a-Si | 1.5 min clean for every 1min of deposition |
| a-Si (max 30min long dep. in one single run) | Wet Clean the Upper Lid/Chamber
DI water then Isopropyl Alcohol on chamber wall & portholes |
| Other films:(max 60min long dep. in one single run) | If > 29min total dep time
(Season + Dep) Wet Clean the Upper Lid/Chamber DI water then Isopropyl Alcohol on chamber wall & portholes |
ICP-PECVD (Unaxis VLR)
2020-02: New recipes have been characterized for low particulate count and repeatability. Only staff-supplied recipes are allowed in the tool. Please follow the new procedures to ensure low particle counts in the chamber.
The system currently has Deuterated Silane (SiD4) installed - identical to the regular Silicon precursor SiH4, except that it significantly lowers optical absorption in the near-infrared due to shifted molecular vibrations/molecular weights. This gas is more expensive and thus more applicable to optical application than to general-purpose SiN films.
Process Control Data (Unaxis ICP-PECVD)
Regularly-run depositions and measurements of film properties over time - executed by NanoFab Interns.
- ICP-PECVD Process Control Plots - Plots of all Process Control data
- Low Deposition Rate SiO2
- High Deposition Rate SiO2
- Si3N4
- Low Stress Si3N4
Low Deposition Rate SiO2 [ICP-PECVD]
- Low Deposition Rate SiO2 [ICP-PECVD] - Standard Recipe - "SiO2 LDR250C-new May 2024
- Low Deposition Rate SiO2 [ICP-PECVD] - Process Control Data
- Lists film data, such as dep rate, stress, particle count, refractive index etc.
Old Data
- Low Deposition Rate SiO2 [ICP-PECVD] - Standard Recipe - "SiO2 LDR250C - replaced on May 2024"
- Old Recipe - 2019
- Low Deposition Rate SiO2 [ICP-PECVD] - Historical Data - before Oct. 2021
High Deposition Rate SiO2 [ICP-PECVD]
- High Deposition Rate SiO2 [ICP-PECVD] - Standard Recipe - "SiO2 HDR250C-new May 2024"
- High Deposition Rate SiO2 [ICP-PECVD] - Current Process Control Data
- Lists film data, such as dep rate, stress, particle count, refractive index etc.
Old Data
- High Deposition Rate SiO2 [ICP-PECVD] - Standard Recipe - "SiO2 HDR250C-replace on May 2024"
- Old Recipe - 2019
- High Deposition Rate SiO2 [ICP-PECVD] - Historical Data
Gap-Fill SiO2 [ICP-PECVD]
Recipe designed by Warren Jin, please consider our publication policy if you publish using this recipe.
NOTE: Please contact tool supervisor before running this recipe - this recipe must often be scheduled to prevent excessive chamber maintenance.
Able to effectively fill ~1:1 and ~1:2 aspect ratio gaps in Silicon and Glass structures (eg. waveguides/optical gratings) with void-free filling.
The recipe uses a high 400W RF Bias to reduce buildup on corners that causes voids during growth.
- Category =
SiO2 GapFill - Std. - FLOW:
SiO2 GapFill 250C- Will run the sequence
SiO2 GapFill 250C 450W. Do not change this!
- Will run the sequence
- STEP (edit TIME only):
SiO2 GapFill 250C - Deposition rate = 99.968nm/min [9/20/23]
Si3N4 [ICP-PECVD]
- Si3N4 [ICP-PECVD] - Standard Recipe - "SiN 250C-new May 2024"
- Si3N4 [ICP-PECVD] - Current Process Control Data
- Lists film data, such as dep rate, stress, particle count, refractive index etc.
Old Data
- Si3N4 [ICP-PECVD] - Standard Recipe - "SiN 250C- replaced on May 2024"
- Old Recipe - 2019
- Si3N4 [ICP-PECVD] - Historical Data - before Oct. 2021
Low Stress Si3N4 [ICP-PECVD]
- Low Stress Si3N4 [ICP-PECVD] - Standard Recipe - "SiN Low Stress 250C-new May 2024"
- Low Stress Si3N4 [ICP-PECVD] - Current Process Control Data
- Lists film data, such as dep rate, stress, particle count, refractive index etc.
Old Data
- Low Stress Si3N4 [ICP-PECVD] - Standard Recipe - "SiN Low Stress 250C - replaced on May 2024"
- Old Recipe - 2019
Standard Seasoning Procedure [ICP-PECVD]
You must edit the seasoning recipes (SiO2 Seasoning - Std, SiN seasoning - Std). You are allowed to change only seasoning time [time needed to coat chamber walls with ~200nm of film]. Seasoning recipes:
Standard Cleaning Procedure [ICP-PECVD]
You must edit the Post-Dep Clean recipe to correspond to your deposited thickness and material. See the Operating Procedure on the Unaxis Tool Page for details.
- SiNx etches at 20nm/min
- SiO2 etches at 40nm/min
Standard Clean Recipe
General Recipe Notes (Unaxis VLR ICP-PECVD)
- RF1 = Bias
- RF2 = ICP Power
- All recipes start with an Argon pre-clean with 0W bias (gentle), to improve adhesion/nucleation.
- Maximum SiO2 Dep. thickness allowed: 800nm
- Above this thickness, you must run a chamber clean/season before depositing more onto your product wafer.