Difference between revisions of "Process Group - Process Control Data"
Jump to navigation
Jump to search
(move TOC below intro) |
(Moved litho to the bottom since it's updated less often) |
||
| Line 5: | Line 5: | ||
__TOC__ |
__TOC__ |
||
| ⚫ | |||
| ⚫ | |||
| − | |||
| ⚫ | |||
| − | |||
| ⚫ | |||
| ⚫ | |||
| ⚫ | |||
| − | |||
| ⚫ | |||
| ⚫ | |[[File:ASML CD Cals - Example Table.jpg|alt=ASML CD Calibration data - Screenshot of Table|none|thumb|300x300px|''Example of Data Table with SEM's of 320nm features. [https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=0 Click for full data table.]''|link=https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=0]] |
||
| ⚫ | |[[File:ASML CD Cals - Example Plot.jpg|alt=ASML CD Calibration Data - Screenshot of SPC Plot|none|thumb|''Example SPC Chart - Measured Critical Dimension "CD" versus Date. [https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=1804752281 Click for charts.]''|link=https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=1804752281]] |
||
| ⚫ | |||
| − | |||
| ⚫ | |||
| ⚫ | |||
=Deposition (Process Control Data)= |
=Deposition (Process Control Data)= |
||
| Line 108: | Line 92: | ||
*[[Oxford ICP Etcher - Process Control Data|InP Ridge Etch with Cl2/CH4/H2 @ 60°C]] - ''No data prior to 2023-01-20'' |
*[[Oxford ICP Etcher - Process Control Data|InP Ridge Etch with Cl2/CH4/H2 @ 60°C]] - ''No data prior to 2023-01-20'' |
||
| + | |||
| + | |||
| ⚫ | |||
| ⚫ | |||
| + | |||
| ⚫ | |||
| ⚫ | |||
| + | |||
| ⚫ | |||
| + | |||
| ⚫ | |||
| ⚫ | |||
| ⚫ | |||
| + | |||
| ⚫ | |||
| ⚫ | |[[File:ASML CD Cals - Example Table.jpg|alt=ASML CD Calibration data - Screenshot of Table|none|thumb|300x300px|''Example of Data Table with SEM's of 320nm features. [https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=0 Click for full data table.]''|link=https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=0]] |
||
| ⚫ | |[[File:ASML CD Cals - Example Plot.jpg|alt=ASML CD Calibration Data - Screenshot of SPC Plot|none|thumb|''Example SPC Chart - Measured Critical Dimension "CD" versus Date. [https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=1804752281 Click for charts.]''|link=https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=1804752281]] |
||
| ⚫ | |||
Latest revision as of 12:03, 24 April 2024
Process Control Data are standardized process, run by staff, allowing for day-to-day or year-by-year comparisons of a tool's performance. This is similar (but not identical to) Statistical Process Control.
These are the same links found on individual tool pages, in the Recipes > <<tool page>> > Process Control section.
Deposition (Process Control Data)
Process Control data for various deposition tools in the lab.
PECVD #1 (PlasmaTherm 790)
PECVD #2 (Advanced Vacuum)
ICP-PECVD (Unaxis VLR Dep)
- ICP-PECVD: Plots of SiO2 Films
- ICP-PECVD: Plots of Si3N4 Films
- ICP-PECVD: SiO2 Low-Dep Rate (LDR)
- ICP-PECVD: SiO2 High-Dep Rate (HDR)
- ICP-PECVD: Si3N4
- ICP-PECVD: Si3N4 Low-Stress
Ion Beam Sputter Deposition (Veeco Nexus)
Old Data (Pre 2022)
Old data in a different format can be found below:
Etching (Process Control Data)
Process Control data for various dry etching tools in the lab.
PlasmaTherm SLR Fluorine Etcher
OLD Process Control Data
- SiO2 Etching with CHF3/CF4 (FL-ICP) - No data prior to 2023-01-20
Panasonic ICP #1
Old Process Control Data
- SiO2 Etch with CHF3/CF4 (Panasonic 1) - No data prior to 2023-01-20
Panasonic ICP#2
Old Process Control Data
- SiO2 Etching with CHF3/CF4 - ICP2 - No data prior to 2023-01-20
Unaxis VLR Etch
Oxford PlasmaPro Cobra Etcher
Calibration / Process testing data taken using the "InP Ridge Etch" process: Cl2/CH4/H2 @ 60°C, 1cm piece with ~50% SiO2 hardmask.
- "Std InP Ridge Etch" Cl2/CH4/H2/60°C - Etch Data Tables
- "Std InP Ridge Etch" Cl2/CH4/H2/60°C - Plots
Old Process Control Data
- InP Ridge Etch with Cl2/CH4/H2 @ 60°C - No data prior to 2023-01-20
Lithography (Process Control Data)
Process Control Data for Nanofab Lithography/patterning tools.
Stepper #3 (ASML DUV)
- The Process Group regularly measures data on lithography Critical Dimension ("CD") and Wafer-stage Particulate Contamination for this tool, using a sensitive lithography process that will reveal small changes in Dose repeatability and wafer flatness.
- Plots of CD Repeatability
- Data for CD Uniformity and Particulate Contamination
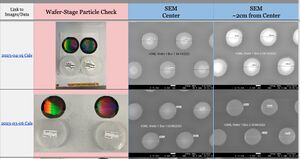 Example of Data Table with SEM's of 320nm features. Click for full data table.
Example of Data Table with SEM's of 320nm features. Click for full data table. Example SPC Chart - Measured Critical Dimension "CD" versus Date. Click for charts.
Example SPC Chart - Measured Critical Dimension "CD" versus Date. Click for charts.



