Process Group - Process Control Data: Difference between revisions
m Litho to Top of page, link to ASML recipes page |
disabled links on example plot images via `|link=` |
||
| (33 intermediate revisions by 2 users not shown) | |||
| Line 1: | Line 1: | ||
Process Control Data are standardized processes, run by the NanoFab, allowing for day-to-day or year-by-year comparisons of a tool's performance at the process level. This is similar [https://en.wikipedia.org/wiki/Statistical_process_control Statistical Process Control (SPC)]. |
|||
These are the same links found on individual tool pages, in the '''''Recipes > <<tool page>> > Process Control''''' section. |
|||
These are the same links are found on individual tool pages, in the '''''<<tool page>> > Process Control''''' section. |
|||
= Lithography (Process Control Data) = |
|||
''Process Control Data for Nanofab Lithography/patterning tools.'' |
|||
__TOC__ |
|||
== [[Stepper_Recipes#Stepper_3_.28ASML_DUV.29|Stepper #3 (ASML DUV)]] == |
|||
Data are collected by our [https://nanofab.ucsb.edu/workforce#internships Process Group Interns] and reviewed by [[Staff List#Process Group|Process Group Staff]]. |
|||
*''The Process Group regularly measures data on lithography Critical Dimension ("CD") and Wafer-stage Particulate Contamination for this tool, using a sensitive lithography process that will reveal small changes in Dose repeatability and wafer flatness.'' |
|||
=Deposition, Dielectric (Process Control Data)= |
|||
*[https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=1804752281 '''Plots of CD Repeatability'''] |
|||
[[File:PECVD SPC Chart Example.png|alt=SPC chart example|thumb|228x228px|Example Process Control Charts (SPC) for thin-film DepCals.|link=]] |
|||
*[https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=0 '''Data for CD Uniformity and Particulate Contamination'''] |
|||
[[File:Surfscan 230113A7G2 after low particles.jpg|alt=screenshot of surfscan particle count|thumb|205x205px|Example particle counts taken on each tool+film.|link=]] |
|||
[[File:PECVD1 SiO2 F50 WaferMap example.jpg|alt=Screenshot of Filmetrics F50 wafermap of typical DepCals film|thumb|215x215px|Example of DepCals Thickness/Refractive Index uniformity measurement (4% shown here).|link=]] |
|||
<hr style="height:5px"> |
|||
<hr style="height:5px"> |
|||
=Deposition (Process Control Data)= |
|||
''Process Control data for various deposition tools in the lab.'' |
''Process Control data for various deposition tools in the lab.'' |
||
==[[PECVD Recipes#PECVD 1 .28PlasmaTherm 790.29|PECVD #1 (PlasmaTherm 790)]]== |
==[[PECVD Recipes#PECVD 1 .28PlasmaTherm 790.29|PECVD #1 (PlasmaTherm 790)]] - Process Control== |
||
*[https://docs.google.com/spreadsheets/d/1fTDNXxpf4tgNYLIEs_jvehG1KvtXqqTRDBI7sHNAVvo/edit#gid=1270764394 PECVD#1: Plots of all data] |
*[https://docs.google.com/spreadsheets/d/1fTDNXxpf4tgNYLIEs_jvehG1KvtXqqTRDBI7sHNAVvo/edit#gid=1270764394 PECVD#1: Plots of all data] |
||
| Line 22: | Line 18: | ||
*[https://docs.google.com/spreadsheets/d/1fTDNXxpf4tgNYLIEs_jvehG1KvtXqqTRDBI7sHNAVvo/edit#gid=98787450 PECVD#1: Si<sub>3</sub>N<sub>4</sub>] |
*[https://docs.google.com/spreadsheets/d/1fTDNXxpf4tgNYLIEs_jvehG1KvtXqqTRDBI7sHNAVvo/edit#gid=98787450 PECVD#1: Si<sub>3</sub>N<sub>4</sub>] |
||
==[[PECVD Recipes#PECVD 2 .28Advanced Vacuum.29|PECVD #2 (Advanced Vacuum)]]== |
==[[PECVD Recipes#PECVD 2 .28Advanced Vacuum.29|PECVD #2 (Advanced Vacuum)]] - Process Control== |
||
*[https://docs.google.com/spreadsheets/d/1iSW1eAAg824y9PYYLG9aiaw53PEJ-f9ofylpVlCDq9Y/edit#gid=272916741 PECVD#2: Plots of all data] |
*[https://docs.google.com/spreadsheets/d/1iSW1eAAg824y9PYYLG9aiaw53PEJ-f9ofylpVlCDq9Y/edit#gid=272916741 PECVD#2: Plots of all data] |
||
| Line 30: | Line 26: | ||
**[https://docs.google.com/spreadsheets/d/1iSW1eAAg824y9PYYLG9aiaw53PEJ-f9ofylpVlCDq9Y/edit#gid=203400760 Plots of Low-Stress Si<sub>3</sub>N<sub>4</sub> Data] |
**[https://docs.google.com/spreadsheets/d/1iSW1eAAg824y9PYYLG9aiaw53PEJ-f9ofylpVlCDq9Y/edit#gid=203400760 Plots of Low-Stress Si<sub>3</sub>N<sub>4</sub> Data] |
||
==[[PECVD Recipes#ICP-PECVD .28Unaxis VLR.29|ICP-PECVD (Unaxis VLR Dep)]]== |
==[[PECVD Recipes#ICP-PECVD .28Unaxis VLR.29|ICP-PECVD (Unaxis VLR Dep)]] - Process Control== |
||
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=417334948https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=417334948 ICP-PECVD: Plots of SiO<sub>2</sub> Films] |
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=417334948https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=417334948 ICP-PECVD: Plots of SiO<sub>2</sub> Films] |
||
| Line 39: | Line 35: | ||
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=1517031044 ICP-PECVD: Si<sub>3</sub>N<sub>4</sub> Low-Stress] |
*[https://docs.google.com/spreadsheets/d/1CuDMKFTTzGLL6CP-FEI_9cOnUaIw-432ppDFssB59wY/edit#gid=1517031044 ICP-PECVD: Si<sub>3</sub>N<sub>4</sub> Low-Stress] |
||
==[[Sputtering Recipes#Ion Beam Deposition .28Veeco NEXUS.29|Ion Beam Sputter Deposition (Veeco Nexus)]]== |
==[[Sputtering Recipes#Ion Beam Deposition .28Veeco NEXUS.29|Ion Beam Sputter Deposition (Veeco Nexus)]] - Process Control== |
||
*[https://docs.google.com/spreadsheets/d/11A0ac8NU51bmcQ_grQcq9wuPwWnfy1_9MNk2DEo5yyo/edit#gid=2030038046 IBD: Plots of all data] |
*[https://docs.google.com/spreadsheets/d/11A0ac8NU51bmcQ_grQcq9wuPwWnfy1_9MNk2DEo5yyo/edit#gid=2030038046 IBD: Plots of all data] |
||
| Line 53: | Line 49: | ||
*[[Old Deposition Data - 2021-12-15]] |
*[[Old Deposition Data - 2021-12-15]] |
||
<hr style="height:5px"> |
|||
<hr style="height:5px"> |
|||
=Deposition, Metal - Process Control Data= |
|||
''Process Control data for various deposition tools in the lab.'' |
|||
== [[Sputter 5 (AJA ATC 2200-V)]] - Process Control == |
|||
[[File:Process Control - Sputter 5 Titanium Sheet Resistance plot.png|alt=Screenshot of Sputter 5 Titanium Sheet Resistance process control chart|thumb|Sputter 5 Titanium - Sheet Resistance - Process Control Chart - '''Example''' data only. |
|||
← click a link for live data.|link=]] |
|||
=== Sputter 5: Ti === |
|||
*[https://docs.google.com/spreadsheets/d/1HiEBTkZdtZmgdtSs619Tnkn-nbCi8BPW9oZYVybjgt4/edit?gid=695635057#gid=695635057 Titanium Datasheet] |
|||
*[https://docs.google.com/spreadsheets/d/1HiEBTkZdtZmgdtSs619Tnkn-nbCi8BPW9oZYVybjgt4/edit?gid=1766775909#gid=1766775909 Titanium Plots] |
|||
=== Sputter 5: Al === |
|||
*[https://docs.google.com/spreadsheets/d/1HiEBTkZdtZmgdtSs619Tnkn-nbCi8BPW9oZYVybjgt4/edit?gid=0#gid=0 Aluminum Datasheet] |
|||
*[https://docs.google.com/spreadsheets/d/1HiEBTkZdtZmgdtSs619Tnkn-nbCi8BPW9oZYVybjgt4/edit?gid=1766775909#gid=1766775909 Aluminum Plots] |
|||
=== Sputter 5: Cr === |
|||
*[https://docs.google.com/spreadsheets/d/1HiEBTkZdtZmgdtSs619Tnkn-nbCi8BPW9oZYVybjgt4/edit?gid=572205583#gid=572205583 Chromium Datasheet] |
|||
*[https://docs.google.com/spreadsheets/d/1HiEBTkZdtZmgdtSs619Tnkn-nbCi8BPW9oZYVybjgt4/edit?gid=1766775909#gid=1766775909 Chromium Plots] |
|||
== [[E-Beam 4 (CHA)]] - Process Control == |
|||
[[File:Process Control - E-Beam 4 Titanium Stress plot.png|alt=Screenshot of E-Beam 4 Titanium Stress - process control chart|thumb|E-Beam 4 Titanium Stress - Process Control Chart. '''Example''' data only - |
|||
← click a link for live data.|link=]] |
|||
=== E-Beam 4: Ti === |
|||
*[https://docs.google.com/spreadsheets/d/1W7OFMAlRIcbpjm7FsbCh9ZLCCbhEp0bhtAC7UqEmJ5U/edit?gid=0#gid=0 Titanium Datasheet] |
|||
*[https://docs.google.com/spreadsheets/d/1W7OFMAlRIcbpjm7FsbCh9ZLCCbhEp0bhtAC7UqEmJ5U/edit?gid=384597990#gid=384597990 Titanium Plots] |
|||
=== E-Beam 4: Au === |
|||
*[https://docs.google.com/spreadsheets/d/1W7OFMAlRIcbpjm7FsbCh9ZLCCbhEp0bhtAC7UqEmJ5U/edit?gid=834604706#gid=834604706 Gold Datasheet] |
|||
*[https://docs.google.com/spreadsheets/d/1W7OFMAlRIcbpjm7FsbCh9ZLCCbhEp0bhtAC7UqEmJ5U/edit?gid=721807140#gid=721807140 Gold Plots] |
|||
=== E-Beam 4: Cr === |
|||
*[https://docs.google.com/spreadsheets/d/1W7OFMAlRIcbpjm7FsbCh9ZLCCbhEp0bhtAC7UqEmJ5U/edit?gid=1629968393#gid=1629968393 Chromium Datasheet] |
|||
*[https://docs.google.com/spreadsheets/d/1W7OFMAlRIcbpjm7FsbCh9ZLCCbhEp0bhtAC7UqEmJ5U/edit?gid=701729811#gid=701729811 Chromium Plots] |
|||
=== E-Beam 4: Ni === |
|||
*[https://docs.google.com/spreadsheets/d/1W7OFMAlRIcbpjm7FsbCh9ZLCCbhEp0bhtAC7UqEmJ5U/edit?gid=649905488#gid=649905488 Nickel Datasheet] |
|||
*[https://docs.google.com/spreadsheets/d/1W7OFMAlRIcbpjm7FsbCh9ZLCCbhEp0bhtAC7UqEmJ5U/edit?gid=1525197973#gid=1525197973 Nickel Plots] |
|||
== [[E-Beam 1 (Sharon)]] - Process Control == |
|||
=== E-Beam 1: Ti === |
|||
*[https://docs.google.com/spreadsheets/d/1biiHilf-DZhizDz2tMp6z7nQBeOYA6r8gnqA1WEHB5A/edit?gid=0#gid=0 Titanium Datasheet] |
|||
*[https://docs.google.com/spreadsheets/d/1biiHilf-DZhizDz2tMp6z7nQBeOYA6r8gnqA1WEHB5A/edit?gid=1305007052#gid=1305007052 Titanium Plots] |
|||
=== E-Beam 1: Au === |
|||
*[https://docs.google.com/spreadsheets/d/1biiHilf-DZhizDz2tMp6z7nQBeOYA6r8gnqA1WEHB5A/edit?gid=1762267354#gid=1762267354 Gold Datasheet] |
|||
*[https://docs.google.com/spreadsheets/d/1biiHilf-DZhizDz2tMp6z7nQBeOYA6r8gnqA1WEHB5A/edit?gid=1245613525#gid=1245613525 Gold Plots] |
|||
=== E-Beam 1: Cr === |
|||
*[https://wiki.nanofab.ucsb.edu/wiki/Process_Group_-_Process_Control_Data?veaction=edit§ion=7 Chromium Datasheet] |
|||
*[https://docs.google.com/spreadsheets/d/1biiHilf-DZhizDz2tMp6z7nQBeOYA6r8gnqA1WEHB5A/edit?gid=424169133#gid=424169133 Chromium Plots] |
|||
=== E-Beam 1: Ni === |
|||
*[https://docs.google.com/spreadsheets/d/1biiHilf-DZhizDz2tMp6z7nQBeOYA6r8gnqA1WEHB5A/edit?gid=679240351#gid=679240351 Nickel Datasheet] |
|||
*[https://docs.google.com/spreadsheets/d/1biiHilf-DZhizDz2tMp6z7nQBeOYA6r8gnqA1WEHB5A/edit?gid=1463522927#gid=1463522927 Nickel Plots] |
|||
<hr style="height:5px"> |
<hr style="height:5px"> |
||
| Line 59: | Line 116: | ||
''Process Control data for various dry etching tools in the lab.'' |
''Process Control data for various dry etching tools in the lab.'' |
||
==[[ICP Etching Recipes#Process Control Data .28Fluorine ICP Etcher.29|PlasmaTherm SLR Fluorine Etcher]]== |
==[[ICP Etching Recipes#Process Control Data .28Fluorine ICP Etcher.29|PlasmaTherm SLR Fluorine Etcher]] - Process Control== |
||
=== SiO<sub>2</sub> Etching (FL-ICP Process Control) === |
|||
*[https://docs.google.com/spreadsheets/d/15hYkCqL3UNNayt4sXrvVi4mBj-OSdnF7PE29mQW9AEY/edit?usp=sharing SiO<sub>2</sub> Etching with CHF3/CF4 - '''Etch Data'''] |
|||
''We have found that SiO<sub>2</sub> etching is fairly insensitive to chamber condition.'' |
|||
*[https://docs.google.com/spreadsheets/d/15hYkCqL3UNNayt4sXrvVi4mBj-OSdnF7PE29mQW9AEY/edit#gid=1804752281 SiO<sub>2</sub> Etching with CHF3/CF4 - '''Plots'''][[File:FL-ICP Process Control Data Example.jpg|alt=example of Process Control Charts|none|thumb|242x242px|[https://docs.google.com/spreadsheets/d/15hYkCqL3UNNayt4sXrvVi4mBj-OSdnF7PE29mQW9AEY/edit#gid=1804752281 Click for Process Control Charts]|link=https://docs.google.com/spreadsheets/d/15hYkCqL3UNNayt4sXrvVi4mBj-OSdnF7PE29mQW9AEY/edit#gid=1804752281]] |
|||
*[https://docs.google.com/spreadsheets/d/15hYkCqL3UNNayt4sXrvVi4mBj-OSdnF7PE29mQW9AEY/edit?usp=sharing SiO<sub>2</sub> Etching with CHF<sub>3</sub>/CF<sub>4</sub> - '''Etch Data'''] |
|||
*[https://docs.google.com/spreadsheets/d/15hYkCqL3UNNayt4sXrvVi4mBj-OSdnF7PE29mQW9AEY/edit#gid=1804752281 SiO<sub>2</sub> Etching with CHF<sub>3</sub>/CF<sub>4</sub> - '''Plots'''][[File:FL-ICP Process Control Data Example.jpg|alt=example of Process Control Charts|none|thumb|242x242px|[https://docs.google.com/spreadsheets/d/15hYkCqL3UNNayt4sXrvVi4mBj-OSdnF7PE29mQW9AEY/edit#gid=1804752281 Click for Process Control Charts]|link=https://docs.google.com/spreadsheets/d/15hYkCqL3UNNayt4sXrvVi4mBj-OSdnF7PE29mQW9AEY/edit#gid=1804752281]] |
|||
==== |
====Old SiO<sub>2</sub> Process Control Data==== |
||
*[[Test Data of Etching SiO2 with CHF3/CF4-Fluorine ICP Etcher|SiO<sub>2</sub> Etching with |
*[[Test Data of Etching SiO2 with CHF3/CF4-Fluorine ICP Etcher|SiO<sub>2</sub> Etching with CHF<sub>3</sub>/CF<sub>4</sub> (FL-ICP]]) - ''No data prior to 2023-01-20'' |
||
== |
=== Si Etching (FL-ICP Process Control) === |
||
''This Si etch is much more sensitive to chamber condition, allowing us to detect chamber contamination faster.'' |
|||
*'''Recipe: [[ICP Etching Recipes#Si Etch Recipes (Fluorine ICP Etcher)|SiVertHFv2]]''' - C<sub>4</sub>F<sub>8</sub>/SF<sub>6</sub>/CF<sub>4</sub> etch of 100mm Silicon Wafer with ~50% open area and resist mask |
|||
*[https://docs.google.com/spreadsheets/d/15iRs-JhfgkMto5rZVtG0hJjcLMiHy039_ahv2nus0UQ/edit?gid=0#gid=0 Si Etching with C<sub>4</sub>F<sub>8</sub>/SF<sub>6</sub>/CF<sub>4</sub> - '''Etch Data'''] |
|||
*[https://docs.google.com/spreadsheets/d/15iRs-JhfgkMto5rZVtG0hJjcLMiHy039_ahv2nus0UQ/edit?gid=1804752281#gid=1804752281 Si Etching with C<sub>4</sub>F<sub>8</sub>/SF<sub>6</sub>/CF<sub>4</sub> - '''Plots'''][[File:FICP-Si.png|alt=example of Process Control Charts|none|thumb|242x242px|[https://docs.google.com/spreadsheets/d/15iRs-JhfgkMto5rZVtG0hJjcLMiHy039_ahv2nus0UQ/edit?gid=1804752281#gid=1804752281 Click for Process Control Charts]|link=https://docs.google.com/spreadsheets/d/15iRs-JhfgkMto5rZVtG0hJjcLMiHy039_ahv2nus0UQ/edit?gid=1804752281#gid=1804752281]] |
|||
==[[ICP Etching Recipes#Process Control Data .28Panasonic 1.29|Panasonic ICP #1]] - Process Control== |
|||
*[https://docs.google.com/spreadsheets/d/1gBqCYXSl7IqpNL-yI11cuURlfZpTWwXUVM9hY_gGpT8/edit?usp=sharing SiO<sub>2</sub> Etch with CHF<sub>3</sub>/CF<sub>4</sub> - '''Etch Data'''] |
*[https://docs.google.com/spreadsheets/d/1gBqCYXSl7IqpNL-yI11cuURlfZpTWwXUVM9hY_gGpT8/edit?usp=sharing SiO<sub>2</sub> Etch with CHF<sub>3</sub>/CF<sub>4</sub> - '''Etch Data'''] |
||
| Line 77: | Line 143: | ||
*[[Test Data of etching SiO2 with CHF3/CF4-ICP1|SiO<sub>2</sub> Etch with CHF<sub>3</sub>/CF<sub>4</sub> (Panasonic 1)]] - ''No data prior to 2023-01-20'' |
*[[Test Data of etching SiO2 with CHF3/CF4-ICP1|SiO<sub>2</sub> Etch with CHF<sub>3</sub>/CF<sub>4</sub> (Panasonic 1)]] - ''No data prior to 2023-01-20'' |
||
==[[ICP Etching Recipes#Process Control Data .28Panasonic 2.29|Panasonic ICP#2]]== |
== [[ICP Etching Recipes#Process Control Data .28Panasonic 2.29|Panasonic ICP#2]] - Process Control == |
||
=== GaAs Etch with N<sub>2</sub>/Cl<sub>2</sub> - Process Control Data (Panasonic 2) === |
|||
*[https://docs.google.com/spreadsheets/d/1m0l_UK2lDxlgww4f6nfXe4aQedNeDZsLs46jQ5wR4zw/edit?usp=sharing SiO2 Etch with CHF3/CF4 - '''Etch Data'''] |
|||
*[https://docs.google.com/spreadsheets/d/1m0l_UK2lDxlgww4f6nfXe4aQedNeDZsLs46jQ5wR4zw/edit#gid=1804752281 SiO2 Etch with CHF3/CF4 - '''Plots'''][[File:ICP2 Process Control Data Example.jpg|alt=example ICP2 process control chart|none|thumb|250x250px|[https://docs.google.com/spreadsheets/d/1m0l_UK2lDxlgww4f6nfXe4aQedNeDZsLs46jQ5wR4zw/edit#gid=1804752281 Click for Process Control Charts]|link=https://docs.google.com/spreadsheets/d/1m0l_UK2lDxlgww4f6nfXe4aQedNeDZsLs46jQ5wR4zw/edit#gid=1804752281]] |
|||
* [https://docs.google.com/spreadsheets/d/16gHOO3PQn_LinrXGPeSTSBf5dnw3leSLh1gq0PLr43w/edit?gid=0#gid=0 GaAs Etch with N2/Cl2 - '''Etch Data'''] |
|||
* [https://docs.google.com/spreadsheets/d/16gHOO3PQn_LinrXGPeSTSBf5dnw3leSLh1gq0PLr43w/edit?gid=1804752281#gid=1804752281 GaAs Etch with N2/Cl2 - '''Plots'''][[File:GaAs_Etch_ICP2_SPC.png|link=https://docs.google.com/spreadsheets/d/16gHOO3PQn_LinrXGPeSTSBf5dnw3leSLh1gq0PLr43w/edit?gid=1804752281#gid=1804752281|alt=example ICP2 process control chart|none|thumb|249x249px|[https://docs.google.com/spreadsheets/d/16gHOO3PQn_LinrXGPeSTSBf5dnw3leSLh1gq0PLr43w/edit?gid=1804752281#gid=1804752281 Click for Process Control Charts]]] |
|||
=== SiO<sub>2</sub> Etch with CHF<sub>3</sub>/CF<sub>4</sub> - Process Control Data (Panasonic 2) === |
|||
*[https://docs.google.com/spreadsheets/d/1m0l_UK2lDxlgww4f6nfXe4aQedNeDZsLs46jQ5wR4zw/edit?usp=sharing SiO<sub>2</sub> Etch with CHF<sub>3</sub>/CF<sub>4</sub> - '''Etch Data'''] |
|||
*[https://docs.google.com/spreadsheets/d/1m0l_UK2lDxlgww4f6nfXe4aQedNeDZsLs46jQ5wR4zw/edit#gid=1804752281 SiO<sub>2</sub> Etch with CHF<sub>3</sub>/CF<sub>4</sub> - '''Plots'''][[File:ICP2 Process Control Data Example.jpg|alt=example ICP2 process control chart|none|thumb|250x250px|[https://docs.google.com/spreadsheets/d/1m0l_UK2lDxlgww4f6nfXe4aQedNeDZsLs46jQ5wR4zw/edit#gid=1804752281 Click for Process Control Charts]|link=https://docs.google.com/spreadsheets/d/1m0l_UK2lDxlgww4f6nfXe4aQedNeDZsLs46jQ5wR4zw/edit#gid=1804752281]] |
|||
====Old Process Control Data==== |
====Old Process Control Data==== |
||
*[[Test Data of etching SiO2 with CHF3/CF4| |
*[[Test Data of etching SiO2 with CHF3/CF4|SiO<sub>2</sub> Etching with CHF<sub>3</sub>/CF<sub>4</sub> - ICP2]] - ''No data prior to 2023-01-20'' |
||
==[[ICP Etching Recipes#Process Control Data .28Unaxis VLR.29|Unaxis VLR Etch]]== |
==[[ICP Etching Recipes#Process Control Data .28Unaxis VLR.29|Unaxis VLR Etch]] - Process Control== |
||
*[[Unaxis VLR Etch - Process Control Data|InP Etching with |
*[[Unaxis VLR Etch - Process Control Data|InP Etching with Cl<sub>2</sub>/H/Ar @ 200°C - Unaxis Etch]] |
||
==[[ICP Etching Recipes#Process Control Data .28Oxford ICP Etcher.29|Oxford PlasmaPro Cobra Etcher]]== |
==[[ICP Etching Recipes#Process Control Data .28Oxford ICP Etcher.29|Oxford PlasmaPro Cobra Etcher]] - Process Control== |
||
''Calibration / Process testing data taken using the "InP Ridge Etch" process: Cl2/CH4/H2 @ 60°C, 1cm piece with ~50% SiO2 hardmask.'' |
|||
=== Std InP Ridge Etch Cl<sub>2</sub>/H<sub>2</sub>/Ar/200°C === |
|||
''Calibration / Process testing data taken using the "InP Ridge Etch" process: Cl2/H2/Ar @ 200°C, 1cm piece with ~50% SiO2 hardmask.'' |
|||
*[https://docs.google.com/spreadsheets/d/1cEUB7K5BAg9N4vp3rPZw7g0orFkxeQmRkX34Fb4eZco/edit#gid=1804752281 "Std InP Ridge Etch" Cl<sub>2</sub>/CH<sub>4</sub>/H<sub>2</sub>/60°C - '''Plots'''][[File:Oxford-ICP-Etch Process Control Data Example.jpg|alt=example SPC chart for Oxford ICP Etcher|none|thumb|225x225px|[https://docs.google.com/spreadsheets/d/1cEUB7K5BAg9N4vp3rPZw7g0orFkxeQmRkX34Fb4eZco/edit#gid=1804752281 Click for Process Control Charts]|link=https://docs.google.com/spreadsheets/d/1cEUB7K5BAg9N4vp3rPZw7g0orFkxeQmRkX34Fb4eZco/edit#gid=1804752281]] |
|||
* [https://docs.google.com/spreadsheets/d/1LE5Cug9uJFYEwu0ZsNsp0W1dTRzcO2EKFhC0wu3w0n4/edit?gid=0#gid=0 "Std InP Ridge Etch" Cl<sub>2</sub>/H<sub>2</sub>/Ar 200°C - '''Etch Data Tables'''] |
|||
====Old Process Control Data==== |
|||
* [https://docs.google.com/spreadsheets/d/1LE5Cug9uJFYEwu0ZsNsp0W1dTRzcO2EKFhC0wu3w0n4/edit?gid=1804752281#gid=1804752281 "Std InP Ridge Etch" Cl<sub>2</sub>/H<sub>2</sub>/Ar 200°C - '''Plots'''] |
|||
[[File:200C InP.png|alt=example SPC chart for Oxford ICP Etcher|none|thumb|276x276px|[https://docs.google.com/spreadsheets/d/1LE5Cug9uJFYEwu0ZsNsp0W1dTRzcO2EKFhC0wu3w0n4/edit?gid=1804752281#gid=1804752281 Click for Process Control Charts]|link=https://docs.google.com/spreadsheets/d/1LE5Cug9uJFYEwu0ZsNsp0W1dTRzcO2EKFhC0wu3w0n4/edit?gid=1804752281#gid=1804752281]] |
|||
=== Std InP Ridge Etch: Cl<sub>2</sub>/CH<sub>4</sub>/H<sub>2</sub>/60°C === |
|||
''Calibration / Process testing data taken using the "InP Ridge Etch" process: Cl2/CH4/H2 @ 60°C, 1cm piece with ~50% SiO2 hardmask. <u>No longer calibrating this recipe.</u>'' |
|||
*[https://docs.google.com/spreadsheets/d/1cEUB7K5BAg9N4vp3rPZw7g0orFkxeQmRkX34Fb4eZco/edit?gid=0#gid=0 "Std InP Ridge Etch" Cl<sub>2</sub>/CH<sub>4</sub>/H<sub>2</sub>/60°C - '''Etch Data Tables'''] |
|||
*[https://docs.google.com/spreadsheets/d/1cEUB7K5BAg9N4vp3rPZw7g0orFkxeQmRkX34Fb4eZco/edit?gid=1552080791#gid=1552080791 "Std InP Ridge Etch" Cl<sub>2</sub>/CH<sub>4</sub>/H<sub>2</sub>/60°C - '''Plots'''][[File:Oxford-ICP-Etch Process Control Data Example.jpg|alt=example SPC chart for Oxford ICP Etcher|none|thumb|276x276px|[https://docs.google.com/spreadsheets/d/1cEUB7K5BAg9N4vp3rPZw7g0orFkxeQmRkX34Fb4eZco/edit#gid=1804752281 Click for Process Control Charts]|link=https://docs.google.com/spreadsheets/d/1cEUB7K5BAg9N4vp3rPZw7g0orFkxeQmRkX34Fb4eZco/edit#gid=1804752281]] |
|||
====Old InP Ridge Etch Data==== |
|||
*[[Oxford ICP Etcher - Process Control Data|InP Ridge Etch with Cl<sub>2</sub>/CH<sub>4</sub>/H<sub>2</sub> @ 60°C]] - ''No data prior to 2023-01-20'' |
|||
=== GaN Etch (Cl2/BCl3/Ar/200°C) === |
|||
Recipe: ''Std GaN Etch - BCl3/Cl2/Ar - 200C (Public)'', on 1cm x 1cm ''~1.2µm deep GaN etch with Cl2/BCl3/Ar at 200°C.'' Sapphire substrate with SiO2 mask for GaN. |
|||
* [https://docs.google.com/spreadsheets/d/1Pk8VwZlZ2lUf3aL9J2El5ZygqHY040TX3ZAMwa33LpE/edit?gid=0#gid=0 GaN Etching with Cl2/BCl3/Ar at 200°C - Etch Data] |
|||
* [https://docs.google.com/spreadsheets/d/1Pk8VwZlZ2lUf3aL9J2El5ZygqHY040TX3ZAMwa33LpE/edit?gid=507237279#gid=507237279 GaN Etching with Cl2/BCl3/Ar at 200°C - Plots][[File:GaN SPC.png|alt=example of Process Control Charts|none|thumb|[https://docs.google.com/spreadsheets/d/1Pk8VwZlZ2lUf3aL9J2El5ZygqHY040TX3ZAMwa33LpE/edit?gid=507237279#gid=507237279 Click for Process Control Charts]|link=https://docs.google.com/spreadsheets/d/1Pk8VwZlZ2lUf3aL9J2El5ZygqHY040TX3ZAMwa33LpE/edit?gid=507237279#gid=507237279]] |
|||
<hr style="height:5px"> |
|||
<hr style="height:5px"> |
|||
== [[DSEIII (PlasmaTherm/Deep Silicon Etcher)|PlasmaTherm DSEIII Deep Silicon Etcher]] - Process Control == |
|||
=== Si Bosch Etching C<sub>4</sub>F<sub>8</sub>/SF<sub>6</sub>/Ar === |
|||
*Recipe: ''STD_Bosch_Si (⭐️Production),'' on 100mm Si Wafer with ~50% open area, photoresist mask, ~40µm deep |
|||
*[https://docs.google.com/spreadsheets/d/1xQcdUH560nT928miZMeP7xxQSwHz_a_EB9s_Kb1LSfg/edit?gid=0#gid=0 Si Etching with C<sub>4</sub>F<sub>8</sub>/SF<sub>6</sub>/Ar - '''Etch Data'''] |
|||
*[https://docs.google.com/spreadsheets/d/1xQcdUH560nT928miZMeP7xxQSwHz_a_EB9s_Kb1LSfg/edit?gid=1804752281#gid=1804752281 Si Etching with C<sub>4</sub>F<sub>8</sub>/SF<sub>6</sub>/Ar - '''Plots'''][[File:DSE plot.png|alt=example of Process Control Charts|none|thumb|[https://docs.google.com/spreadsheets/d/1xQcdUH560nT928miZMeP7xxQSwHz_a_EB9s_Kb1LSfg/edit?gid=1804752281#gid=1804752281 Click for Process Control Charts]|link=https://docs.google.com/spreadsheets/d/1xQcdUH560nT928miZMeP7xxQSwHz_a_EB9s_Kb1LSfg/edit?gid=1804752281#gid=1804752281]] |
|||
<hr style="height:5px"> |
|||
<hr style="height:5px"> |
|||
=Lithography (Process Control Data)= |
|||
''Process Control Data for Nanofab Lithography/patterning tools.'' |
|||
==[[Stepper_Recipes#Stepper_3_.28ASML_DUV.29|Stepper #3 (ASML DUV)]] - Process Control== |
|||
*''The Process Group regularly measures data on lithography Critical Dimension ("CD") and Wafer-stage Particulate Contamination for this tool, using a sensitive lithography process that will reveal small changes in Dose repeatability and wafer flatness.'' |
|||
*[https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=1804752281 '''Plots of CD Repeatability'''] |
|||
*[https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=0 '''Data for CD Uniformity and Particulate Contamination'''] |
|||
:{| |
|||
*[[Oxford ICP Etcher - Process Control Data|InP Ridge Etch with Cl2/CH4/H2 @ 60°C]] - ''No data prior to 2023-01-20'' |
|||
|[[File:ASML CD Cals - Example Table.jpg|alt=ASML CD Calibration data - Screenshot of Table|none|thumb|300x300px|''Example of Data Table with SEM's of 320nm features. [https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=0 Click for full data table.]''|link=https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=0]] |
|||
|[[File:ASML CD Cals - Example Plot.jpg|alt=ASML CD Calibration Data - Screenshot of SPC Plot|none|thumb|''Example SPC Chart - Measured Critical Dimension "CD" versus Date. [https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=1804752281 Click for charts.]''|link=https://docs.google.com/spreadsheets/d/1xW1TFH_QjPMWl9T1jiKzwmYe4B2wg7KY-nqOKUoXttI/edit#gid=1804752281]] |
|||
|} |
|||
Latest revision as of 01:45, 12 February 2026
Process Control Data are standardized processes, run by the NanoFab, allowing for day-to-day or year-by-year comparisons of a tool's performance at the process level. This is similar Statistical Process Control (SPC).
These are the same links are found on individual tool pages, in the <<tool page>> > Process Control section.
Data are collected by our Process Group Interns and reviewed by Process Group Staff.
Deposition, Dielectric (Process Control Data)


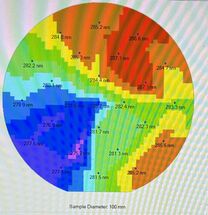
Process Control data for various deposition tools in the lab.
PECVD #1 (PlasmaTherm 790) - Process Control
PECVD #2 (Advanced Vacuum) - Process Control
ICP-PECVD (Unaxis VLR Dep) - Process Control
- ICP-PECVD: Plots of SiO2 Films
- ICP-PECVD: Plots of Si3N4 Films
- ICP-PECVD: SiO2 Low-Dep Rate (LDR)
- ICP-PECVD: SiO2 High-Dep Rate (HDR)
- ICP-PECVD: Si3N4
- ICP-PECVD: Si3N4 Low-Stress
Ion Beam Sputter Deposition (Veeco Nexus) - Process Control
Old Data (Pre 2022)
Old data in a different format can be found below:
Deposition, Metal - Process Control Data
Process Control data for various deposition tools in the lab.
Sputter 5 (AJA ATC 2200-V) - Process Control

Sputter 5: Ti
Sputter 5: Al
Sputter 5: Cr
E-Beam 4 (CHA) - Process Control

E-Beam 4: Ti
E-Beam 4: Au
E-Beam 4: Cr
E-Beam 4: Ni
E-Beam 1 (Sharon) - Process Control
E-Beam 1: Ti
E-Beam 1: Au
E-Beam 1: Cr
E-Beam 1: Ni
Etching (Process Control Data)
Process Control data for various dry etching tools in the lab.
PlasmaTherm SLR Fluorine Etcher - Process Control
SiO2 Etching (FL-ICP Process Control)
We have found that SiO2 etching is fairly insensitive to chamber condition.
- SiO2 Etching with CHF3/CF4 - Etch Data
- SiO2 Etching with CHF3/CF4 - Plots

Click for Process Control Charts
Old SiO2 Process Control Data
- SiO2 Etching with CHF3/CF4 (FL-ICP) - No data prior to 2023-01-20
Si Etching (FL-ICP Process Control)
This Si etch is much more sensitive to chamber condition, allowing us to detect chamber contamination faster.
- Recipe: SiVertHFv2 - C4F8/SF6/CF4 etch of 100mm Silicon Wafer with ~50% open area and resist mask
- Si Etching with C4F8/SF6/CF4 - Etch Data
- Si Etching with C4F8/SF6/CF4 - Plots

Click for Process Control Charts
Panasonic ICP #1 - Process Control
Old Process Control Data
- SiO2 Etch with CHF3/CF4 (Panasonic 1) - No data prior to 2023-01-20
Panasonic ICP#2 - Process Control
GaAs Etch with N2/Cl2 - Process Control Data (Panasonic 2)
SiO2 Etch with CHF3/CF4 - Process Control Data (Panasonic 2)
Old Process Control Data
- SiO2 Etching with CHF3/CF4 - ICP2 - No data prior to 2023-01-20
Unaxis VLR Etch - Process Control
Oxford PlasmaPro Cobra Etcher - Process Control
Std InP Ridge Etch Cl2/H2/Ar/200°C
Calibration / Process testing data taken using the "InP Ridge Etch" process: Cl2/H2/Ar @ 200°C, 1cm piece with ~50% SiO2 hardmask.
- "Std InP Ridge Etch" Cl2/H2/Ar 200°C - Etch Data Tables
- "Std InP Ridge Etch" Cl2/H2/Ar 200°C - Plots

Std InP Ridge Etch: Cl2/CH4/H2/60°C
Calibration / Process testing data taken using the "InP Ridge Etch" process: Cl2/CH4/H2 @ 60°C, 1cm piece with ~50% SiO2 hardmask. No longer calibrating this recipe.
- "Std InP Ridge Etch" Cl2/CH4/H2/60°C - Etch Data Tables
- "Std InP Ridge Etch" Cl2/CH4/H2/60°C - Plots

Click for Process Control Charts
Old InP Ridge Etch Data
- InP Ridge Etch with Cl2/CH4/H2 @ 60°C - No data prior to 2023-01-20
GaN Etch (Cl2/BCl3/Ar/200°C)
Recipe: Std GaN Etch - BCl3/Cl2/Ar - 200C (Public), on 1cm x 1cm ~1.2µm deep GaN etch with Cl2/BCl3/Ar at 200°C. Sapphire substrate with SiO2 mask for GaN.
- GaN Etching with Cl2/BCl3/Ar at 200°C - Etch Data
- GaN Etching with Cl2/BCl3/Ar at 200°C - Plots
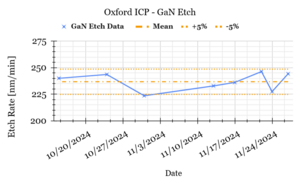
Click for Process Control Charts
PlasmaTherm DSEIII Deep Silicon Etcher - Process Control
Si Bosch Etching C4F8/SF6/Ar
- Recipe: STD_Bosch_Si (⭐️Production), on 100mm Si Wafer with ~50% open area, photoresist mask, ~40µm deep
- Si Etching with C4F8/SF6/Ar - Etch Data
- Si Etching with C4F8/SF6/Ar - Plots

Click for Process Control Charts
Lithography (Process Control Data)
Process Control Data for Nanofab Lithography/patterning tools.
Stepper #3 (ASML DUV) - Process Control
- The Process Group regularly measures data on lithography Critical Dimension ("CD") and Wafer-stage Particulate Contamination for this tool, using a sensitive lithography process that will reveal small changes in Dose repeatability and wafer flatness.
- Plots of CD Repeatability
- Data for CD Uniformity and Particulate Contamination
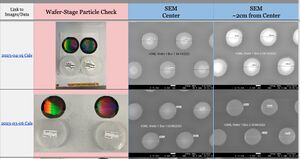
Example of Data Table with SEM's of 320nm features. Click for full data table. 
Example SPC Chart - Measured Critical Dimension "CD" versus Date. Click for charts.


